Einführung
Dreidimensionale Verbindungen mit Through-Silicon-Via (TSV) wurden entwickelt, um die Bandbreite zu erhöhen, die Latenz zu verringern und den Stromverbrauch in modernen Chips zu senken. Sie dienen dazu, verschiedene Schichten eines Die-Stacks direkt durch das Substrat zu verbinden. Typische Abmessungen von TSVs liegen im Bereich von 5 bis 150 um für den Durchmesser und 20 bis 200 um für die Durchkontaktierungslänge. Die Verwendung von TSVs ermöglicht eine effiziente Verbindungstechnik, die im Vergleich zu herkömmlichen Drahtbondtechniken, wie in Abbildung 1 dargestellt, zu einem kompakteren Chipdesign und -gehäuse führt.
Obwohl das Stapeln von 3D-ICs in Speicher- und Bildsensoren aufgrund von thermischen und Kostenproblemen nicht häufig eingesetzt wurde, wurden von Xilinx Silizium-Interposer auf TSV-Basis eingesetzt, um FPGA-Systeme (Field-Programmable Gate Array) mit 28 Gbit/s und einer 2,5D-Architektur zu demonstrieren.
In diesem Artikel werden wir die Leistung eines Through Silicon Via (TSV) modellieren und bewerten, indem wir ein einzelnes TSV mit dem numerischen Simulator HFWorks in Solidworks isolieren. Ein Through Silicon Via wird mit Solidworks entworfen und mithilfe der S-Parameter-Analyse in HFWorks simuliert.
Design und Simulation
Abbildung 2 zeigt den mit Solidworks entworfenen TSV-Anschluss. Diese Anwendung besteht aus TSV in einer Siliziumbox, die in der HFWorks-Umgebung von einer Airbox umgeben ist. Die Siliziumbox wurde mit einem spezifischen Widerstand von 10 Ω · cm ausgewählt. Das implementierte TSV ist ein 50 &mgr; m langer Kupferstab mit einem Querschnittsdurchmesser von 5 &mgr; m.
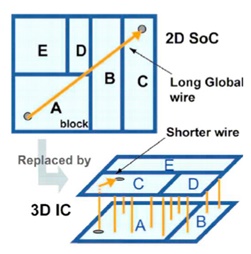
Abbildung 1 - Drahtverbindungsvergleich zwischen 2D-IC und 3D-IC.
Es ist mit einer Schicht aus Siliciumdioxid mit einer Dicke von 0,5 um bedeckt, um das TSV vom Substrat zu isolieren. Die obere und die untere Platte des TSV werden als Wave-Port ausgewählt, um die Erregungen mit einer Impedanz von 50 Ohm anzulegen.
![]()
Abbildung 2 - Das 3D-Solidworks-Modell des Through Silicon Via TSV.
Die schematische Darstellung des Steckverbinders TSV ist in Abbildung 3 dargestellt. Die verwendeten geometrischen Parameter und Werkstoffe sind in Tabelle 1 zusammengefasst.
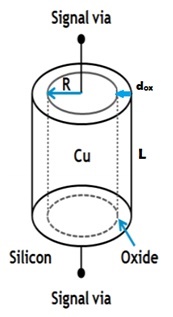
Abbildung 3 - Schematisches Digaram eines einzelnen TSV
Tabelle1 - Maßangaben des Steckverbinders
| Parameter | Wert | Teile | Materialien |
| R | 2,5 um | TSV Körper | Kupfer |
| d ox | 0,5 um | Dielektrikum | Siliciumdioxid |
| L | 50 um | Silikonschachtel | Silizium |
| Luft Box | Luft |
Ergebnisse
Die Variationen des S-Parameters S11 sind in 4 beschrieben. Wie erwartet zeigt es einen geringen Einfügungsverlust bei hohen Frequenzen, was hauptsächlich auf das Vorhandensein von drei Grundmoden innerhalb der Struktur zurückzuführen ist, nämlich dem Slow-Wave-Modus, dem dielektrischen Quasi-TEM-Modus und dem Skin-Effekt-Modus. Die scharfe Steigung zeigt den Übergang von der langsamen Welle zum Quasi-TEM-Modus an.
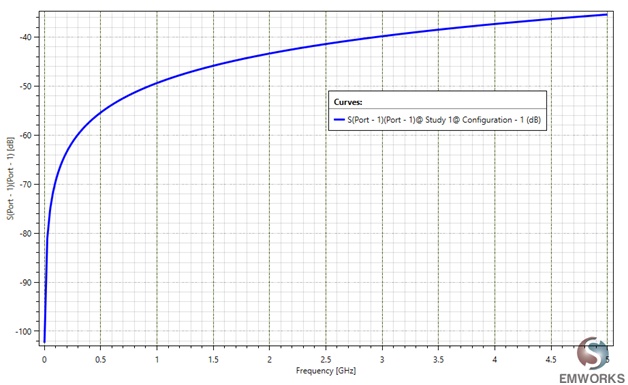
Abbildung 4 - Rückflussdämpfung S11 des einzelnen TSV
Das Diagramm der Einfügungsdämpfung S21 in Abbildung 5 zeigt an, dass das Eingangssignal bei 1 GHz um weniger als 0,00005 dB gedämpft ist. Dies ist ein relativ gutes Ergebnis, da wir erwarten, dass S21 nahe bei 0 liegt.
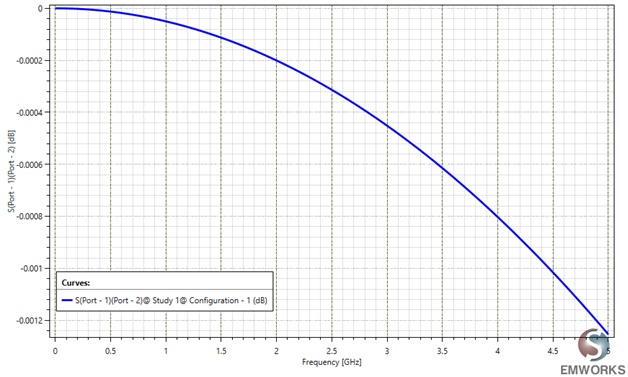
Abbildung 5 - Einfügungsverlust S21 des einzelnen TSV
Die Verteilung des elektrischen Feldes bei 1 GHz ist in Abbildung 6 dargestellt. Es ist klar, dass das elektrische Feld gleichmäßig entlang des fehlerfreien TSV innerhalb des Substrats verteilt ist.

Abbildung 6 - Verteilung des elektrischen Feldes bei 1 GHz des einzelnen TSV
Fazit
Dieser Artikel beschreibt die in HFWorks for Solidworks implementierte 3D Through Silicon Via (TSV) -Struktur. Der Einfügungsverlust, der Rückflussverlust und die Verteilung des elektrischen Feldes wurden unter Verwendung der S-Parameter-Studie in HFWorks bestimmt. Die in HFWorks erzielten Ergebnisse stimmen mit den in Literaturangaben [1] angegebenen erwarteten Werten überein.
Verweise
[1] Gong, Zheng, "TSV Equivalent Circuit Model using 3D Full-Wave Analysis" (2014). Electronic Theses and Dissertations. Paper 5238.

